
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.
전자소자의 소형화, 다기능화, 고소비전력화, 신뢰성 향상 등의 급속한 발전으로 인해 마이크로전자소자의 고밀도 3차원 집적 기술이 등장하게 되었다. 그러나 고밀도 집적화의 개발은 칩 내부의 열 집중으로 인한 접합 온도 상승으로 인해 제한되어 장치 성능과 신뢰성이 크게 저하됩니다.
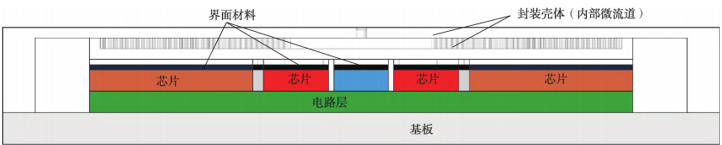
통합 칩은 기판 레이어, 칩 회로 레이어, 칩 및 패키지 쉘 냉각판으로 구성된 다층 구조를 갖추고 있습니다. 패키지 쉘 냉각판에는 액체 대류 열 전달을 통해 회로층 칩에서 열을 방출하는 동시에 균일한 칩 온도 분포를 보장하는 마이크로채널이 통합되어 있습니다. 유연한 열 인터페이스 재료(TIM)는 패키지 쉘 냉각판과 회로 레이어 사이의 인터페이스를 연결합니다.
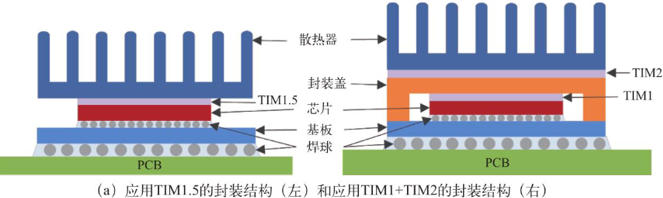
열 인터페이스 재료(TIM)는 표면 사이의 미세한 틈을 채워 열 성능을 직접적으로 향상시키는 중요한 방열 구성 요소입니다. TIM은 일반적으로 칩과 패키지 덮개(TIM1), 칩과 방열판(TIM1.5), 패키지 덮개와 방열판(TIM2) 사이에 적용됩니다. TIM의 높은 열 전도성과 신뢰성은 인터페이스 전반에 걸쳐 빠른 열 전달을 보장합니다. 고성능 컴퓨팅 칩에 널리 사용되는 열 관리 접근 방식은 여전히 초저 열 저항 TIM1 소재를 사용하여 칩 내부에서 패키지 하우징으로 열을 빠르게 전도하는 것입니다. 그런 다음 열은 TIM2 재료를 통해 액체 냉각판으로 전달되며, 내부 냉각 유체의 빠른 흐름을 통해 외부 환경으로 빠르게 방출됩니다.

March 05, 2026
March 04, 2026
July 22, 2025
July 16, 2025
이 업체에게 이메일로 보내기
March 05, 2026
March 04, 2026
July 22, 2025
July 16, 2025

Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.

Fill in more information so that we can get in touch with you faster
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.